Já em maio, a ASML, líder no segmento de scanners de litografia, falou sobre as perspectivas de surgimento até o início da próxima década de sistemas que permitam trabalhar com um valor de abertura numérica ultra-alto de 0,75 (Hyper-NA EUV). Representantes do Imec afirmam que a litografia continuará a utilizar lasers e silício na próxima década.
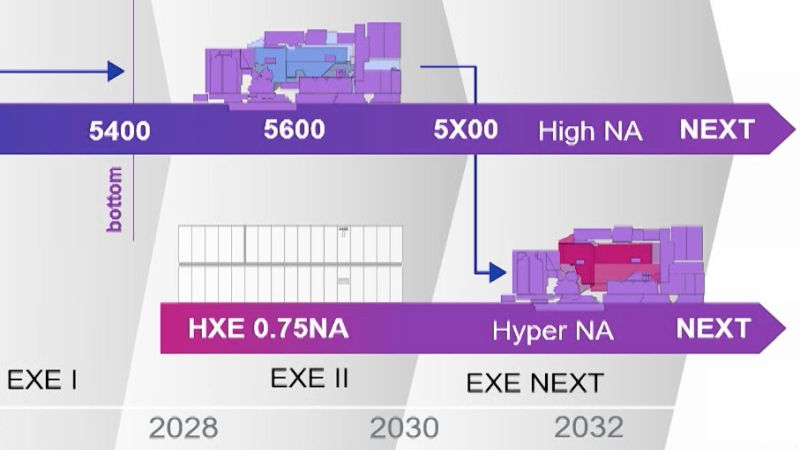
Fonte da imagem: ASML
Kurt Ronse, diretor de programas avançados de exposições do Imec, compartilhou essas idéias em uma entrevista ao EE Times. Esta empresa belga tem ajudado a ASML a dominar novas tecnologias no desenvolvimento de scanners litográficos há mais de 30 anos, por isso tem todo o direito de falar sobre as perspectivas para o seu desenvolvimento futuro. Enquanto o fabricante do equipamento se prepara para migrar para scanners de litografia de alta abertura numérica (0,55) (High-NA EUV), ele enfrenta alguns desafios.
Em particular, neste valor da abertura numérica, a polarização da luz começa a se manifestar, reduzindo o contraste da imagem projetada na pastilha de silício. Para combatê-lo, podem ser utilizados filtros polarizadores, mas aumentam o consumo de energia dos equipamentos e o custo de produção. Ao mudar para o Hyper-NA EUV, como explica um representante do Imec, o problema será a busca por novos materiais fotorresistentes, pois mesmo com um valor numérico de abertura de 0,55, a espessura de sua camada diminui, e isso prejudica a precisão dos processos químicos subsequentes. gravura.
De acordo com Kurt Ronse, a TSMC não tem pressa em mudar para High-NA EUV devido à experiência da empresa com múltiplas máscaras fotográficas. A Intel não tem experiência suficiente nesse aspecto e, portanto, prefere simplesmente mudar para equipamentos mais caros e com maior resolução. O uso de estêncil duplo exigiria um posicionamento mais preciso das máscaras fotográficas. A Intel simplesmente não tem experiência suficiente nesta área. De acordo com um representante do Imec, a TSMC decidirá mudar para High-NA EUV no final da década atual.
Em geral, esses equipamentos terão aplicação na produção de chips utilizando padrões litográficos mais finos que 2 nm – até 7 angstroms. Depois disso, será necessário utilizar scanners de litografia com abertura numérica ultra-alta (Hyper-NA EUV). Tal transição eliminará modelos duplos, uma vez que o último método aumenta os custos de ferramentas e prolonga o ciclo de produção, aumentando os custos de produção.
Os pesquisadores têm considerado diversas alternativas aos equipamentos de litografia de abertura numérica ultra-alta, segundo o Imec. Uma delas é a tecnologia de transistores de nanoimpressão, mas em termos de desempenho esse método é muito inferior até mesmo ao scanner EUV de alto NA. Outra alternativa era usar múltiplos fluxos direcionados de elétrons para formar o padrão desejado em um wafer de silício, mas o único fabricante de equipamento adequado faliu.
A utilização de novos materiais em vez do silício ainda é difícil, como explica um representante do Imec. Existem materiais com maior mobilidade eletrônica, mas são muito difíceis de aplicar em um wafer que ainda permanecerá silício. Equipamentos para aplicação de novos materiais serão combinados com novos produtos químicos, e experimentos já estão em andamento em laboratórios, mas ainda estão longe de serem amplamente utilizados.