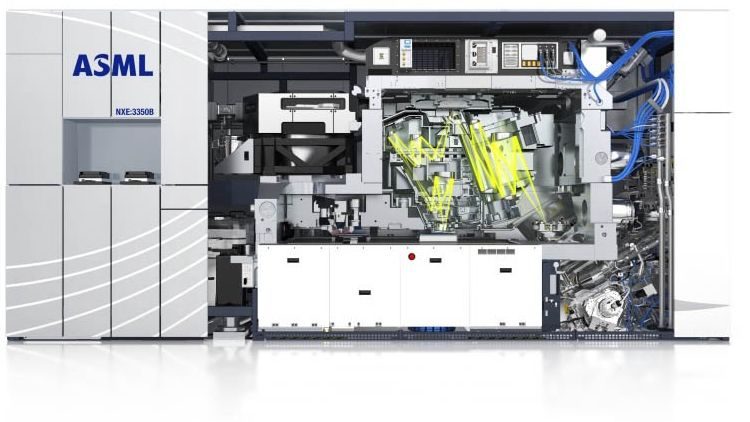
A litografia ultravioleta ultravioleta (EUV) tornou possível encolher transistores em chips semicondutores sem aumentar ainda mais o número de fotomáscaras. A sua implementação foi atrasada vários anos desde a data original, mas agora está a ficar claro que a litografia EUV da próxima geração também será atrasada.
Fonte da imagem: ASML
Conforme observado por Arne Verheyde, um dos contribuintes regulares do Buscando Alpha, TSMC e Samsung começou a usar litografia ultravioleta ultravioleta relativamente recentemente, como o desenvolvimento de tecnologias de 7nm e 5nm, a Intel também anunciou planos semelhantes, embora originalmente acreditasse que essa transição começaria tão cedo quanto a tecnologia de 32 nm. O comprimento de onda do laser usado na litografia foi de 193 nm (DUV) por muitos anos, e na litografia EUV teve que ser reduzido para 13,5 nm. Como a transição de DUV para EUV foi atrasada, os fabricantes de chips foram forçados a implementar primeiro a chamada litografia de imersão, que permitiu aumentar o índice de refração de 1,0 para 1,35, e então alcançar a redução no tamanho dos transistores através do uso de muitas fotomáscaras.
Na primeira metade da última década, Intel, TSMC e Samsung, como clientes interessados na adoção antecipada da litografia EUV, compraram grandes participações na ASML por vários bilhões de dólares americanos. Ironicamente, a Intel, que mais gastou, acabou entre as que estão a recuperar, uma vez que fará a transição para a litografia EUV no âmbito da produção em massa não antes do final do próximo ano. É óbvio que outros clientes ASML dominaram a litografia EUV mais tarde do que o esperado originalmente.
O próximo passo tecnológico deve ser a transição para a litografia EUV com alto índice de refração (alto NA EUV). O fato é que a redução do comprimento do laser de 193 para 13,5 nm como parte da migração do DUV reduziu o índice de refração de 1,35 para 0,35. A transição para o próximo estágio no desenvolvimento da litografia EUV deve elevar esse número para 0,55. Isso reduzirá ainda mais o tamanho dos transistores sem aumentar excessivamente o número de fotomáscaras.
A ASML, conforme observado, na conferência de relatórios de janeiro anunciou que estava atrasando a implementação da nova versão do EUV por pelo menos três anos. Anteriormente, acreditava-se que a tecnologia estaria dominada até 2023, e agora a implementação da versão EUV com alto valor de índice de refração está adiada para 2025 ou 2026. A indústria já experimentou um atraso na introdução da primeira geração do EUV, por isso continuará a compensar a falta de progresso por parte dos scanners litográficos aumentando o número de fotomáscaras. Para os usuários finais, isso significa que o custo de dominar novos processos tecnológicos em litografia continuará a aumentar. Na verdade, um scanner para EUV de alto NA custará cerca de US $ 300 milhões, mas reduzirá os custos com ferramentas e acelerará o processamento de pastilhas de silício. Nas condições atuais, a ASML poderá lucrar com a venda de equipamentos EUV de primeira geração. Só neste ano, ela vai aumentar sua receita principal em 30%.